Inspección de semiconductores
Los fabricantes y proveedores necesitan lograr una inspección y un análisis de semiconductores rápidos y fiables para el procesamiento de obleas, así como para el empaquetado, el montaje y las pruebas de circuitos integrados (IC). La conformidad con las especificaciones definidas durante la fabricación de semiconductores es fundamental para su fiabilidad. Para producir dispositivos semiconductores y chips IC de alta calidad, se debe cumplir el nivel de limpieza esperado y la presencia mínima de defectos. Por lo tanto, las soluciones de microscopía para una inspección eficiente de obleas y semiconductores son cruciales para alcanzar este objetivo. Además, la demanda de tecnología de mayor rendimiento también es constante, por lo que estos microscopios deberían contribuir a la investigación y desarrollo.
Póngase en contacto con nosotros para obtener asesoramiento experto sobre nuestras soluciones de microscopía para inspección de semiconductores.
¿Por qué es importante la inspección de obleas y semiconductores?
La inspección de obleas y semiconductores es importante durante la producción, ya que ayuda a garantizar la calidad y fiabilidad de los chips IC y otros componentes electrónicos. Implica la detección y el análisis de defectos, rayas o contaminación (partículas, residuos, etc.) que pueden producirse durante el proceso de fabricación. Dichos defectos o contaminación podrían dañar el rendimiento de los componentes, causar fallos o interrumpir el flujo fluido de la producción.
¿Cómo puede lograr una inspección eficiente de obleas y semiconductores?
La inspección visual eficiente se puede realizar con microscopía óptica utilizando una variedad de métodos de iluminación y contraste (campo claro, campo oscuro, polarización, DIC, UV, iluminación oblicua, IR) y una gama de aumentos. Se pueden detectar y analizar de forma rápida y fiable diversos defectos, rayas y contaminación en obleas y semiconductores.
¿Por qué la inspección de semiconductores puede requerir análisis de sección transversal?
Los defectos pueden aparecer en los materiales de los componentes semiconductores, como los chips IC (circuitos integrados) y durante la producción, afectando a la calidad y fiabilidad de los componentes. Para comprobar estos defectos, ya que los materiales suelen ser opacos, a veces es necesario realizar un análisis de sección transversal. La estructura interna de los componentes semiconductores no se puede ver sin realizar primero la preparación de la sección transversal. A continuación, se realiza un análisis para observar y analizar cualquier defecto que pueda estar presente en la estructura interna.
Obtenga su solución individual basada en 3 cortas preguntas.
Configuraciones especializadas disponibles para sus necesidades específicas. Responda el cuestionario para encontrar la solución adecuada a sus necesidades. Si prefiere que un representante se ponga en contacto con usted, haga clic aquí para rellenar su información de contacto.
CONTÁCTENOS{{ question.questionText }}
Seleccione una respuesta!
Mejor partido
{{ resultProduct.header }}
{{ resultProduct.subheader }}
{{ resultProduct.description }}
{{ resultProduct.features }}
Solicite su paquete informativo
Retos de la inspección de obleas y semiconductores
Al inspeccionar obleas y semiconductores, puede resultar difícil optimizar el flujo de trabajo, ya que los usuarios deben:
- Pasar de forma eficiente de una visión general de la oblea o el semiconductor a ver los detalles finos
- Visualizar de forma rápida y fiable diferentes tipos de defectos, rayas, residuos, contaminación, etc.
- Trabaje de una manera cómoda que permita un rendimiento de inspección mejorado.
Estos desafíos de inspección se pueden superar con las soluciones de microscopía adecuadas.
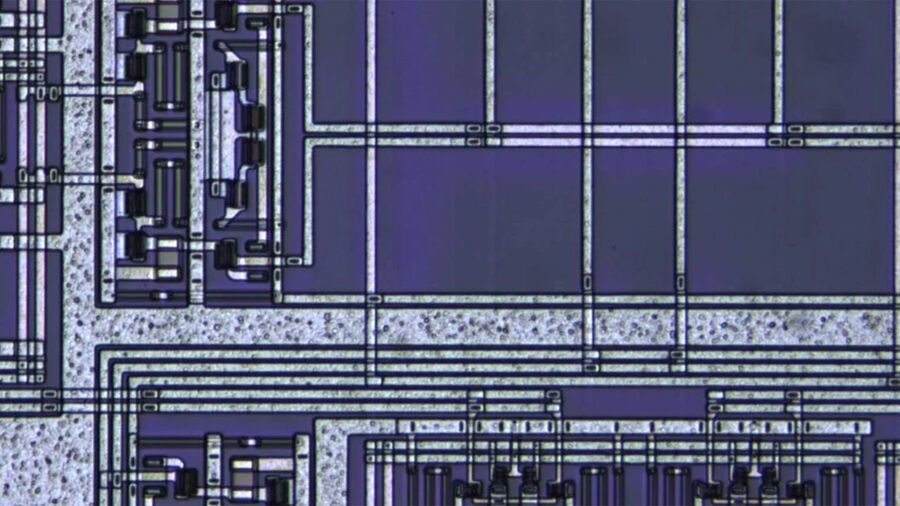
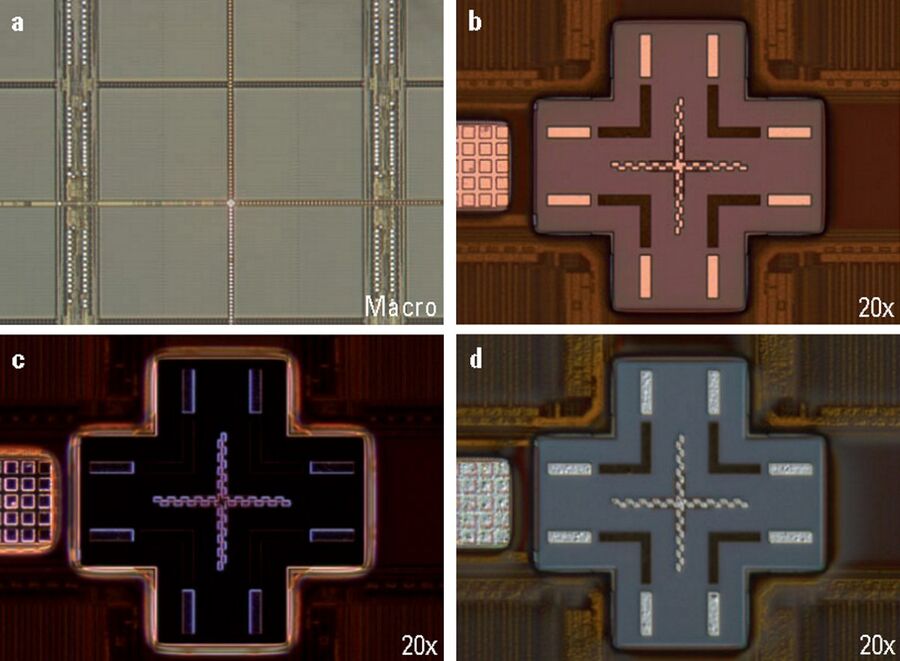
Vea más con diversos métodos de contraste
Para lograr una inspección de obleas y un control de calidad (QC) más eficientes y fiables, es crucial visualizar fácilmente los detalles difíciles de ver. Cuando se utiliza una solución de microscopía para la inspección, la calidad de la imagen, en términos de contraste y nivel de detalle fácilmente visible, depende en gran medida de la iluminación y la óptica.
La elección de la iluminación y el método de contraste adecuados, como la iluminación de campo claro, campo oscuro, UV y oblicua, puede ser imperativa. Los distintos defectos de las obleas y los chips IC, p.ej. la contaminación, los residuos, los recubrimientos deformados, las rayas, etc., a menudo pueden ser más visibles con un método de contraste que con otros.
Preparación y análisis de la sección transversal
Para examinar la estructura interna de los componentes semiconductores, como los chips IC, es necesario preparar y analizar secciones transversales debido a los materiales opacos. El análisis de sección transversal es un método valioso para la inspección, junto con el análisis de fallos y la I+D. Requiere cortar un componente semiconductor y, a continuación, esmerilar y pulir la sección transversal hasta obtener una superficie lisa.
El análisis de sección transversal se puede realizar con microscopía óptica únicamente. Si se combina la microscopía con la espectroscopía láser, se revelan simultáneamente tanto la estructura interna como la composición de los componentes semiconductores.
Preguntas frecuentes sobre la inspección de semiconductores
La fabricación de semiconductores es el proceso en el que se producen chips de circuito integrado (IC). En primer lugar, se depositan finas capas de conductoras y aislantes sobre una oblea hecha de un material semiconductor como el silicio (Si). A continuación, se forman nanopatrones al depositar una capa fotorresistente en la parte superior de la lámina, exponiéndola a la luz UV a través de una máscara y, después, grabando las áreas expuestas. Después de lavar la fotorresistencia, la conductividad eléctrica de los patrones se ajusta mediante el bombardeo de iones y se crean los IC. Finalmente, la oblea con el patrón se corta en chips IC que se montan en una placa de circuito impreso (PCB).
La fabricación de semiconductores requiere varios procesos y pasos para producir componentes electrónicos como chips IC (circuitos integrados). Implica una gama de procesos y equipos de nanofabricación como la litografía UV, el grabado en seco y en húmedo y los haces de iones. Debido a las pequeñas dimensiones de los nanopatrones, se debe evitar el polvo y otra contaminación, ya que de lo contrario se pueden producir defectos graves. Por este motivo, la fabricación de semiconductores se realiza en una sala blanca. La inspección mediante microscopios ópticos y otras técnicas es una parte importante de la fabricación. Se lleva a cabo regularmente para garantizar que haya pocos o ningún defecto y una alta calidad de los componentes.